재료 개선으로 실리콘 영역 확대해 방열 성능↑

[시사저널e=고명훈 기자] 삼성전자가 반도체 3D 패키지 기술로 모바일 애플리케이션 프로세서(AP) 수율을 올렸다. 패키지 기술을 기반으로 AP 발열 개선에 집중할 계획이다.
10일 반도체업계에 따르면 삼성전자는 지난달 말 미국 콜로라도주 덴버에서 개최한 제74회 전자부품기술학회(ECTC)에서 ‘모바일 AP를 위한 고성능 3D 패키지 기술’ 논문을 발표했다.
해당 논문에서 삼성전자는 모바일 AP 패키지에 열압착(TC) 본딩 기술을 도입하고, 언더필(칩과 칩 사이의 간격을 액체 형태의 절연 수지로 채우는 것) 재료 개선을 통해 안정적인 3D 패키지 수율을 확보한 사례를 설명했다.
3D 패키지는 서로 다른 기능의 칩을 수직 형태로 하나의 패키징으로 통합하는 기술이다. 그간 메모리 반도체 제조에서 주로 활용돼왔으나, 최근에는 시스템 반도체에서도 미세 공정 기술의 구조적 성능 한계를 극복하한 기술로 주목받는다.
이중 삼성전자는 웨이퍼레벨패키지(WLP) 방식을 채택해 모바일 AP 제조에 적용하고 있다. WLP는 웨이퍼 상태에서 전기적 연결과 몰딩 작업까지 마친 후 잘라서 칩을 만드는 방식으로, 칩 크기 그대로 패키징할 수 있어 모바일과 같은 초소형 제품을 만드는 데 유리하다.
연구에서 삼성전자는 웨이퍼레벨에서 상부와 하부 칩을 연결할 때 TC 본딩 기술을 도입했다. TC 본딩은 칩을 위로 쌓아 올린 다음 실리콘 관통전극(TSV)으로 연결하고, 솔더 범프를 집어넣어 열압착 방식으로 접합하는 기법이다. TC 본딩을 할 때는 칩 사이에 비전도성절연필름(NCF)를 덧대는데, 열과 압력을 가할 때 이 필름이 녹으면서 범프 간 연결을 유도한다.
삼성전자는 TC 본딩에서 NCF 적용 영역을 늘려 칩 모서리까지 채울 수 있도록 하는 등 범프 밀도를 확대하는 데 집중했다. 반도체 내 최대한 많은 범프를 넣기 위해서다. 그 결과 범프 간격을 25um(마이크로미터)로 유지했으며, 이를 통해 총 10만개 이상의 범프를 넣을 수 있게 됐다.
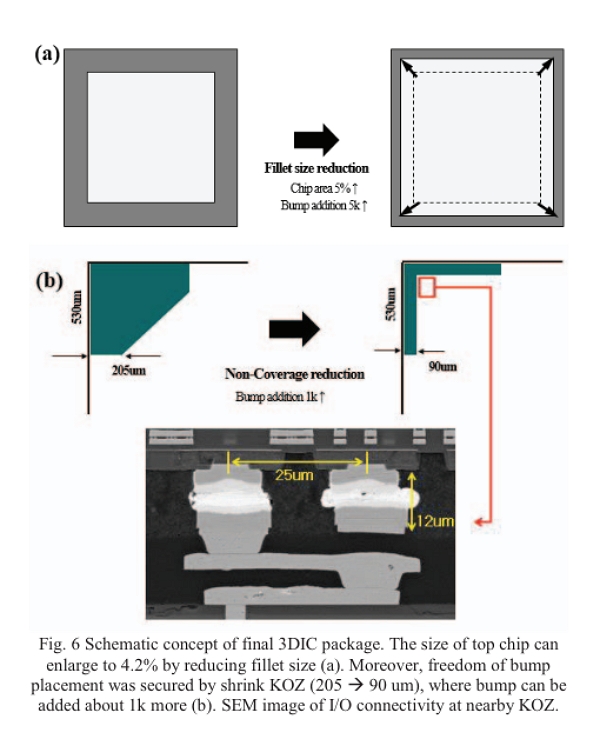
삼성전자는 기존 언더필 공정에서 사용하던 재료를 개선함으로써 필렛을 줄이는 데도 성공했다. 필렛은 접합된 칩 다이 주변으로 수지 등이 흘러나오는 것을 말한다. 필렛을 최소화해야 실리콘 영역이 커지면서 방열 성능도 향상되는데, 삼성전자는 이번 재료 개선을 통해 실리콘 영역을 기존보다 4.2%가량 확대했다고 밝혔다.
삼성전자는 해당 논문에서 “이번 실험 결과를 통해 웨이퍼 테스트에서 97% 이상의 조립 수율을 확보했으며, 향후 다양한 장치에 이러한 논리를 적용한다면 효율을 더욱 높일 수 있을 것”이라고 말했다.
발열을 잡는 것은 모바일 AP 성능을 최대한 안정적으로 사용하기 위한 중요 요소로 지목된다. 삼성전자도 그간 자체 모바일 AP를 탑재한 스마트폰에 발열 문제가 불거지면서 칩 생산수율 저조에 대한 논란에 휩싸이기도 했다.
삼성전자는 이후 안정적인 수율 확보를 위해 패키지 기술 강화에 집중하고 있다. 올 초 출시한 모바일 AP ‘엑시노스 2400’에는 처음으로 팬아웃(FO)-WLP 방식을 도입해 효과적으로 발열 개선을 이뤄냈단 평가다.
FO는 솔더볼을 칩 영역 바깥으로 넘어가서 배치해 입출력을 늘리는 기술로, 칩 밑에 덧대는 기판을 별도로 사용하지 않기 때문에 칩 두께를 줄이고 전력효율을 개선할 수 있단 장점이 있다. 삼성전자는 엑시노스에 FO-WLP를 적용함으로써 기존 대비 내열성을 23%가량 향상했다고 설명했다.
