삼성전자 HBM 패키징 공급처로 앰코 등 외산 기업 채택 유력
하나마이크론, RDL·2.5D 등 연구 진행 중이나 시간 걸릴 듯
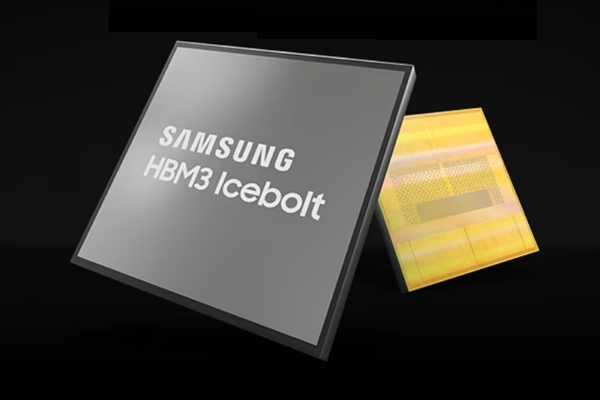
[시사저널e=고명훈 기자] 삼성전자 고대역폭메모리(HBM) 후공정 수혜 기업은 토종업체보다 앰코테크놀로지 등 외산 기업이 될 가능성이 크단 전망이다. 국내 삼성전자 협력사가 물량을 받는 시점은 수요가 더 늘어나고 기술 성숙도가 더 높아진 이후가 될 것으로 보인다.
7일 반도체업계에 따르면 토종 후공정 업계는 삼성전자 HBM 패키지 수혜 가능성을 낮게 보고 있다. 후공정 업체 관계자는 “HBM 물량 자체가 상당히 올라와야만 효과가 나오는 것이고, 단기적으로는 국내 패키징 업체들이 수혜를 보기는 어려울 것”이라고 말했다.
이 관계자는 “HBM 공정 중 부가가치가 떨어지고 기술 난도가 낮은 공정 등에 대해서도 삼성전자는 생상능력이 보장된 글로벌 순위권 기업들과 하려고 하지, 토종 업체에 대한 배정은 시기상조라고 본다”고 설명했다.
이같은 분위기는 삼성전자가 엔비디아 AI 반도체향 HBM3(4세대) 양산을 본격화하면 국내 주요 반도체 패키징 업체들이 수혜를 입을 것이란 전망과는 다르다.
삼성전자는 HBM을 하나의 패키지로 구현한 2.5D 패키지 기술 ‘아이큐브(I-Cube)4’를 만들고 양산을 준비 중이다. 이는 실리콘 인터포저로 여러 칩을 묶어 연결하는 방식으로, TSMC의 2.5D 패키징 ‘CoWoS(Chip on Wafer on Substrate)’와 유사한 구조다.
TSMC는 CoWoS 그래픽처리장치(GPU)와 인터포저를 붙이는 메인 공정은 직접 하지만, 그 외 인터포저와 HBM, FC-BGA 등을 붙이는 작업은 ASE·앰코테크놀로지(앰코) 등 에 맡긴다. 삼성전자도 일부 후공정을 관련 업체에 외주를 줄 수 있단 분석이 나오면서 토종 후공정 업체들이 주목받았다.
당장은 외산 기업 기술을 쓸 수밖에 없는 상황이란 것이 반도체 업계 중론이다. 삼성전자가 엔비디아에 공급하는 HBM3 양산을 본격화할 때까지 국내 기업들의 생산능력이 받쳐주지 않는다면, 여건이 충분한 외국 기업으로 눈을 돌리는 것 말고는 여지가 없기 때문이다.
반도체업계는 삼성전자가 글로벌 후공정 시장 2위 업체인 미국 앰코와 협업을 검토할 것으로 본다. 대만 기업들이 후공정 시장을 장악한 가운데, 앰코는 미국 기업이면서도 TSMC향 CoWoS 증설에 투자를 지속하고 있다. 이 때문에 패키징 역량 강화를 고민하는 삼성이 앰코를 인수할 것이라는 소문이 돌기도 했다.
국내 업계도 준비를 시작했다. 하나마이크론은 HBM 패키지에서 사용하는 재배선(RDL) 공정과 2.5D 패키징 등 관련 기술들을 연구소 차원에서 준비하고 있다고 밝혔다. 다만, 실제 양산 단계에 진입하기 위해서는 상당한 시간이 소요될 것으로 예상된다.
또 다른 업계 관계자는 “(삼성전자의 HBM에 따른 국내 OSAT 업체들의 수혜 전망과 관련해) 지금 어떻다고 말하기에는 너무 이르다”라며 “이제 막 엔비디아의 품질 테스트를 마친 단계”라고 지적했다.
